Popüler Telefon Sızıntısı Olası Çıktı, Doğrulama Yetersiz
Isı kısıtları 3D paketlemeyi erteledi; şirketler üretim süreçlerini iyileştirmeye odaklandı.
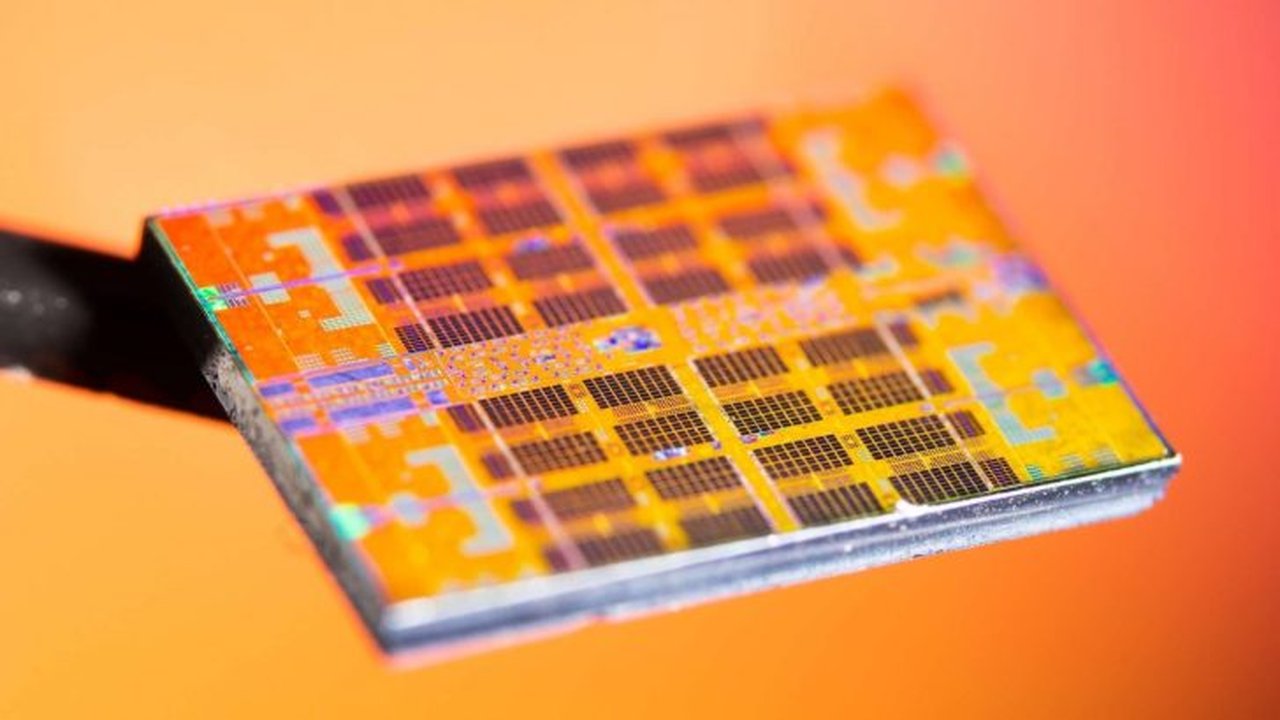
- 0-20%: Olası değil – Güvenilir kaynak eksik
- 21-40%: Şüpheli – Bazı kaygılar devam ediyor
- 41-60%: Olası – Makul kanıt
- 61-80%: Muhtemel – Güçlü kanıt
- 81-100%: Çok Muhtemel – Birden fazla güvenilir kaynak
60%
Olası
3D paketleme, akıllı telefon yonga setlerinin performans tavanını aşma potansiyeli nedeniyle gündeme geldi; bununla birlikte termal zorluklar sektörde yoğun şekilde tartışılıyor. Bir ipucu verene göre TSMC, Huawei ve Apple gibi firmalar 3D paketlemeyi değerlendiriyor; özellikle Apple’ın M5 Pro ve M5 Max için 2.5D paketleme kullanma planları bu tartışmayı ateşledi.
3D paketleme akıllı telefonlar için neden çekici?
Akıllı telefon yonga setlerinde en büyük engel ısı dağılımı. TSMC’nin 2nm işlemi bazı verimlilik iyileştirmeleri getirecek şekilde bekleniyor ve bu da üretim süreçlerinin geliştirilmesini öne çıkarıyor.
Bununla birlikte yonga setlerinin karmaşıklığı ve boyutu arttıkça, performans sınırını aşmak için paketleme yaklaşımlarını değiştirmek gerekiyor.
Hangi şirketler 3D paketlemeyi konuşuyor ve hangi adımları atıyor?
İpucu verene göre sektör TSMC ve Huawei gibi isimlerin 3D paketlemeyi tartıştığını gösteriyor. Öte yandan bu firmalar, mevcut bilgilere göre, öncelikle üretim süreçlerini iyileştirmeye odaklanıyor.
Apple ise M5 Pro ve M5 Max ile 2.5D paketlemeye geçiş yapıyor; bu durum 3D paketleme tartışmalarını canlı tutuyor.
Isı yönetimi ve teknik zorluklar nelerdir?
Sunucu veya masaüstü işlemcilerde güçlü soğutma çözümleri sayesinde 3D paketleme daha uygulanabilir oluyor. Akıllı telefonlarda ise buhar odaları ve bazen küçük fanlar dışında sınırlı bir ısı uzaklaştırma alanı bulunuyor.
3D paketleme, çipleri üst üste istifleyerek büyük bir ısı kaynağı oluşturuyor ve alt katmanlardaki ısının kaçışını zorlaştırıyor. Bu nedenle termal tasarım 3D paketlemenin önündeki en büyük engel olarak öne çıkıyor.
Bu alandaki mevcut çözümler ve şirketlerin stratejileri nelerdir?
Samsung kısa süre önce Exynos 2600’de Heat Pass Block (HPB) çözümünü sundu; bu yöntem silikon die üzerine bakır soğutucu yerleştirerek sıcaklıkları azaltmayı hedefliyor. Öte yandan HPB, 3D paketlemenin getirdiği termal sorunlar için yeterli görünmüyor.
Bununla birlikte sektörde ileri düğüm geliştirmelerinin (ör. 2nm) artık tüketici ilgisini aynı şekilde etkilemediği görüşü yaygınlaşıyor. Bu nedenle Apple, Qualcomm ve MediaTek gibi firmalar mimari iyileştirmelere yöneliyor.
Önemli noktalar
- 3D paketleme çiplerin üst üste istiflenmesini içerir ve bu durum ciddi termal zorluklar yaratır.
- Samsung, Exynos 2600’de Heat Pass Block (HPB) ile ısı yönetimine yeni yaklaşım getirdi.
- Apple’ın M5 Pro ve M5 Max modelleri 2.5D paketleme kullanacak şekilde planlanıyor; InFO yerine 2.5D’ye geçiş söz konusu.
- Endüstri konuşmalarında TSMC ve Huawei’nin 3D paketlemeyi tartıştığı belirtiliyor, ancak firmalar öncelikle üretim süreçlerini iyileştiriyor.
Bununla birlikte, eğer 3D paketlemeyi benimseme ihtimali olan bir şirket varsa, o şirketin Apple olması muhtemel görünüyor. Öte yandan bu teknoloji muhtemelen M serisi SoC’lerle sınırlı kalacak; A serisine yayılması termal ödünler nedeniyle olası görünmüyor.
Sonuç olarak, M5 Pro ve M5 Max’in 2.5D paketlemeyi kullanması Apple’a 3D teknolojisini keşfetme fırsatı verebilir; ancak bu geçişin gerçekleşmesi yıllar alabilir. Öte yandan akıllı telefon yonga setleri büyük olasılıkla geleneksel paketlemeyle devam edecek, fakat firmalar alternatif çözümler aramaya devam edecek.
Bu gelişmelerin mobil performans ve ısı yönetimi üzerindeki etkileri önemli; yorumlarınızı paylaşarak tartışmaya katılabilirsiniz.